
IC封装载板用低轮廓电解铜箔
IC载板材料包含铜箔基板树脂、Prepreg(胶片)、增层绝缘薄膜、电解铜箔、超薄铜箔、防焊材料、低热膨胀玻纤、低介电玻纤、干膜光阻及镀铜液等。
IC载板可细分为ABF载板及BT载板。材料叠构方面,ABF载板主要由中间一层铜箔基板(树脂+电解铜箔)作为核心层,再依据需要的板层数压合增层绝缘薄膜(Build-up Film)而成,BT载板则是以Prepreg(胶片)作为增层材料。除了材料上的差异,ABF载板的外层铜箔(绝缘材料上的底铜层)是由电路板厂直接在增层绝缘薄膜上化学镀铜(Electroless Copper Plating)而成。BT载板则是先层压超薄电解铜箔在Prepreg上,最后再在超薄铜箔上化学镀铜。ABF与BT载板之线路形成、材料叠层结构与外层铜箔形成方式之差异:见下图
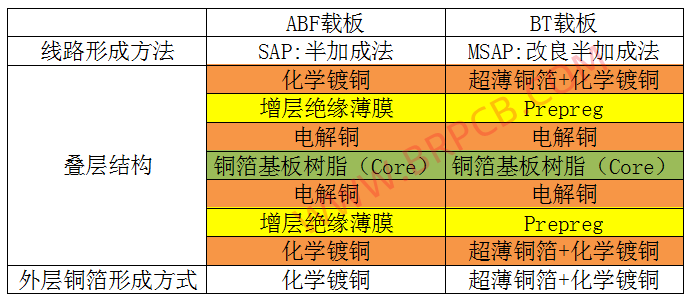
IC封装载板(包括模块基板)要求的超薄低轮廓电解铜箔应具有高温下(210℃/1h处理后)的高抗拉强度性、高热稳定性、高弹性模量、高剥离强度。它的厚度规格为5.0μm~12μm。并且近年高端IC封装载板用超薄铜箔的厚度规格正向着更极薄化发展,即厚度达到1.5μm~3μm。
IC封装载板(包括模块基板)近年也出现高频高速化的需求。因此,近年出现了更多的封装载板用超薄低轮廓电解铜箔品种。例如:三井金属的3EC- M2S- VLP(无载体),Rz≤1.8 μm (典型值);210℃/1h 后的抗拉强度51kgf/mm 2 ;延伸率4.6%;铜箔最薄规格9μm。三井金属的MT18FL(有载体),Rz≤1.3μm ,形成电路铜箔的规格1.5、2、3μm。日进材料有限公司的LPF(无载体),Rz≤1.72(典型值),210℃/1h 后的抗拉强度52.3kgf/mm 2 ;延伸率3.7%;铜箔最薄规格9μm。
前段时间一篇来自海外PCB专家撰写的论文,对超薄、低轮廓铜箔的应用市场及应用性能要求作了较精辟的阐述。文中提出:“自2017年后,HDI板开始大量采用在IC载板产品上已经是普遍应用的线路电镀工艺。这种工艺被称为半加成法工艺(SAP),是利用线路电镀技术,以满足IC载板小于15um的线路结构需求,这种工艺在一般HDI板尚未采用,不过利用超薄铜皮做半加成技术(MSAP)的调整后,已经成为HDI制造的主流工艺。”
“IC载板运用的半加成法(SAP)与类载板(SLP)的带铜箔半加成法(MSAP)的差异在于加工的板材是否是预压超薄铜箔。目前市场通常情况下,成熟的SAP工艺加工的都是ABF薄膜材料,采用全板沉铜工艺,这并不适合现存多数生产设备的设置;因此就催生了改良型方案,即带超薄铜箔的半加成工艺技术。”
文中给出了带超薄铜箔的半加成法(MSAP)的工艺路线对比图(见图),笔者在此上标出了“预压超薄铜箔”的位置,以便读者有明晰的了解。
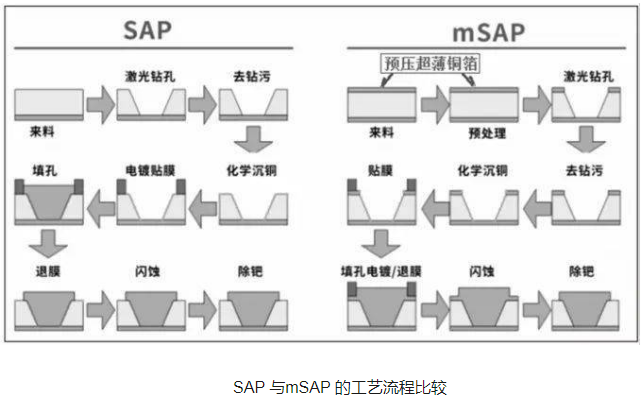
该文提出:“带铜箔半加成法工艺的关键就是使用了载体铜,这有助于铜箔的抗剥离强度稳定且加强纤维的支撑。”但是,文中也同时提到了采用压合法覆在基材上的超薄铜箔,在微细电路、微孔激光加工中所应达到的几项重要性能。它主要包括:较高的并稳定的铜箔抗剥离强度、超薄铜箔的厚度均匀性、低表面粗糙度、铜箔光面上适宜的抗氧化涂层、微细线路的蚀刻性等。其中,铜箔抗剥离强度是最重要的性能项目。