
PCB硬板的最高工艺类载板(SLP)
SLP(substrate-like PCB),也叫类载板(SLP),是下一代PCB硬板,它本是HDI板, 但其规格已接近IC封装载板的等级了。类载板仍是PCB硬板的一种,只是在制程上更接近IC封装载板。
类载板(SLP)将取代之前的HDI PCB技术,可将线宽/线距从HDI的40/50um缩短到20/35um,即最小线宽/线距将从HDI的50um缩短到SLP的30um以内,目前博锐电路SLP制程已经可以做到30um。目前类载板要求的线宽/线距为≤30um/30um ,无法采用减成法生产,需要使用mSAP (改良型半加成法)制程技术。即将封装基板和载板功能集于一身的基板材料。但制造工艺、原材料和设计方案(一片还是多片)都还没有定论。
类载板(SLP)催产者是苹果新款手机,在2017年的iPhone 8中,首度采用以接近IC制程生产的类载板的HDI板,可让手机尺寸更轻薄短小。类载板的基材也与IC封装载板相似,主要是BT树脂的CCL与ABF树脂的积层介质膜。
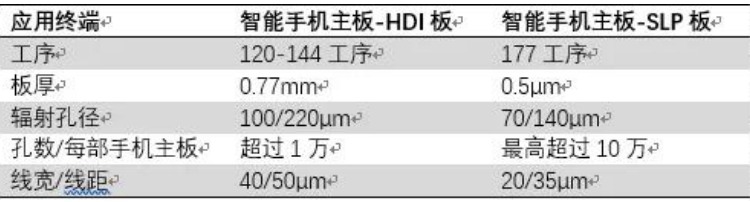
SLP出现的机遇
受智能手机、平板电脑和穿戴设备等电子产品不断向智能化、小型化和功能多样化的发展趋势,PCB上需要搭载的元器件大幅度增加但要求的尺寸、重量、体积却不断缩小。在这样的背景下,PCB导线宽度、间距,微孔盘的直径和孔中心距离,以及导体层和绝缘层的厚度要求都在不断下降,而传统HDI受限于制程难以满足以上要求。因此堆叠层数更多、线宽线距更小、可以承载更多功能模组的SLP技术成为解决这一问题的必然选择。
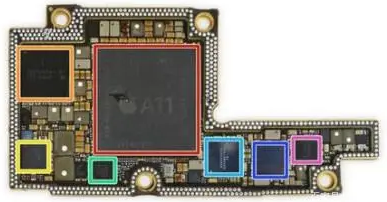
从制程上来看,SLP更接近用于半导体封装的IC载板,但尚未达到IC载板的规格,而其用途仍是搭载各种主被动元器件,因此仍属于PCB的范畴。智能手机用SLP板,同样面积电子元器件承载数量可以达到HDI的两倍。用同样功能的PCB,SLP能够大幅度减小HDI板的面积和厚度,厚度减少约30%,面积减小约50%,能够为电子产品腾出更多空间发展新硬件或增加电池容量。
SLP技术
SLP适配SIP封装技术,SLP需求的一大提升方向在于其与SIP封装技术的契合。根据国际半导体路线组织(ITRS )的定义SIP(System in a Package)即系统级封装技术,是多个具有不同功能的有源电子元件与可选无源器件,例如包括处理器、存储器、MEMS等功能芯片和光学器件等集成在一个封装内,实现一定功能的单个标准封装件,从而实现一个基本完整的功能,形成一个系统或者子系统的封装技术。实现电子整机系统的功能通常有两种途径,包括统单芯片SOC(System on Chip)与系统化封装SIP。
SOC是指将原本不同功能的IC,整合在一颗芯片中实现电子整机系统。近年来由于半导体制程的提升愈发困难,SOC发展遭遇技术瓶颈,SIP成为电子产业新的产业技术潮流。对于SIP而言,由于系统级封装内部走线的密度非常高,普通的PCB板难以承载,而类载板SLP更加契合密度要求,适合作为SIP的封装载体。
目前在印制线路板和IC封装载板制造工艺中,主要有减成法、全加成法与半加成法三种工艺技术。